最近、大手 ニュース 半導体業界から突如として現れた。日本のCMP(化学機械研磨)スラリー大手のAGC(旧旭硝子株式会社)が供給停止を発表した。Fab1用DSTIスラリー(材料番号:M2701505、AGC-TW)の供給停止が報じられている。この突然の展開は業界関係者の注目を集めている。

アナリストは、供給混乱の直接的な原因は、台湾が主要な半導体化学品に対して導入した新たな輸出審査政策にあると指摘している。この政策は、特定のハイエンド材料の輸出に対する規制を厳格化するもので、高度な製造プロセスに必要な複数の製品モデルに影響を与えている。
AGCは台湾に生産拠点を構え、主にアジア市場へ供給しています。そのため、中国本土の複数の下流ウェーハ工場は、代替品の検討を急いでいます。一部の工場では、海外サプライヤーや国内メーカーからの調達を増やし始めています。しかしながら、短期的には供給逼迫が続く可能性があります。
CMP:ウェーハ用超平坦ステージ
集積回路技術の進歩、特にサブミクロン時代においては、微細化とデバイス密度の向上が求められ、層間平坦性の重要性がますます高まっています。その結果、半導体基板に対する超精密表面処理と高い表面品質への需要は高まり続けています。
現在、化学機械研磨(CMPCMP(CMP)は、グローバル平坦化を実現できる唯一のキーテクノロジーです。集積回路部品の最小加工寸法が7nm、さらには5nmへと微細化するにつれ、CMP技術はここ数十年で急速に進歩しました。その研磨精度は現在、ナノメートルレベルに達し、半導体製造において広く採用されています。
CMPはナノスケール集積回路製造における標準プロセスとなり、ムーアの法則の継続的な発展を支えています。半導体プロセスにおいて、CMPはウェーハ表面の高度に平坦な状態を確保し、リソグラフィやエッチングなどの後続工程の強固な基盤を提供します。これは、先端チップ製造において不可欠なプロセスです。
スラリーの主要材料におけるブレークスルーの緊急の必要性
CMPは、研磨液と対象材料間の化学反応、およびスラリー中の研磨粒子の機械的作用を組み合わせることで、材料を除去し、表面全体の平坦性を実現します。
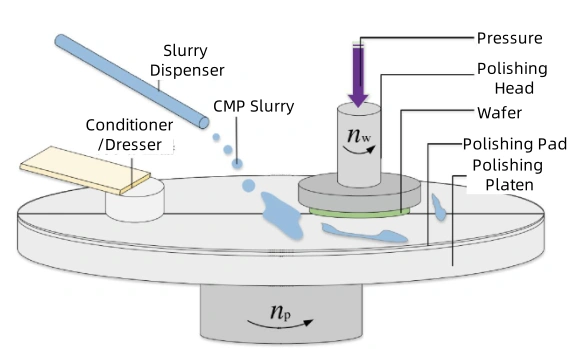
そのため、研磨液はCMPプロセスにおける中核消耗品の一つであり、その性能は研磨効率とチップ表面品質に直接影響を及ぼします。
現在、世界のCMPスラリー市場は高度に集中しており、米国と日本のメーカーが市場の80%以上を占めています。特にハイエンド分野では日本企業が優位に立っています。
一部の中国企業は低価格帯および中価格帯の製品では代替品の導入を実現しているものの、中高級品の自給率は依然として20%を下回っており、国産代替品の早急な導入が求められている。
中高級研磨液の自給率が低い主な理由の 1 つは、主要な原材料の現地調達が不完全であることです。
例えば研磨剤について考えてみましょう。CMPで最も一般的に使用される研磨剤は、Al₂O₃、SiO₂、CeO₂の3つです。これらは、ウェーハ表面から材料を除去するために必要な機械的な力を生み出すため、CMPスラリーの重要な原料となります。
まとめ
SMICやHuahong Semiconductorなどの企業では、14nm以下の製造ラインで月間1,000トン以上の研磨スラリーを消費していると報告されています。供給が途絶えると、生産ラインの停止につながる可能性があります。
大手ウェーハファブは、研磨スラリーの在庫は通常1~2か月しか持たないと発表しました。供給混乱が続くと、第3四半期の生産能力は10%減少する可能性があり、状況は極めて緊迫しています。
この事件は警告となる。サプライチェーンのセキュリティは機器やチップに限定されず、研磨スラリーなどの重要な消耗品や高純度アルミナなどの上流材料も含まれるが、どちらも依然として脆弱なボトルネックとなっている。
中国の半導体材料部門は、対外依存度を低減するための取り組みを加速させる必要がある。さもなければ、同様の危機が再発し、中国の半導体産業の長期的な発展を脅かす可能性がある。
エピックパウダー
材料加工における信頼できるパートナーとして、 エピックパウダーマシナリー 高性能粉砕・分級装置の製造を専門とする当社は、微粉体技術に関する深い専門知識を活かし、アルミナ、シリカ、その他の高純度粉末といった主要材料の製造において、カスタマイズされたソリューションを提供することで、半導体・電子材料産業を支援しています。